随着摩尔定律的逐步失效,芯片行业的发展更多的将目光放到先进封装,在众多先进封装技术中,晶圆级封装和面板级封装是两大主流技术路线,迄今为止,面板级封装由于工艺成熟度较低,设备、材料等供应较为短缺,导致在市场还是少数。
然而,面板级封装相对晶圆级封装有着极大的天然优势,比如面板级封装比晶圆级封装有更高的芯片密度。如300x300mm的面板比12寸(300mm)的晶圆可以多容纳1.64倍的晶粒,而对比面板与晶圆两者的工艺,经有供应商可以提供700mmx700mm的面板,但是晶圆的大小由于供应链及成本等原因,中长期内必将仍然停留在12寸,也是300mm,同时、晶圆级封装上出现的Partial DIE(Edge缺陷DIE)将不会在面板级封装中出现。
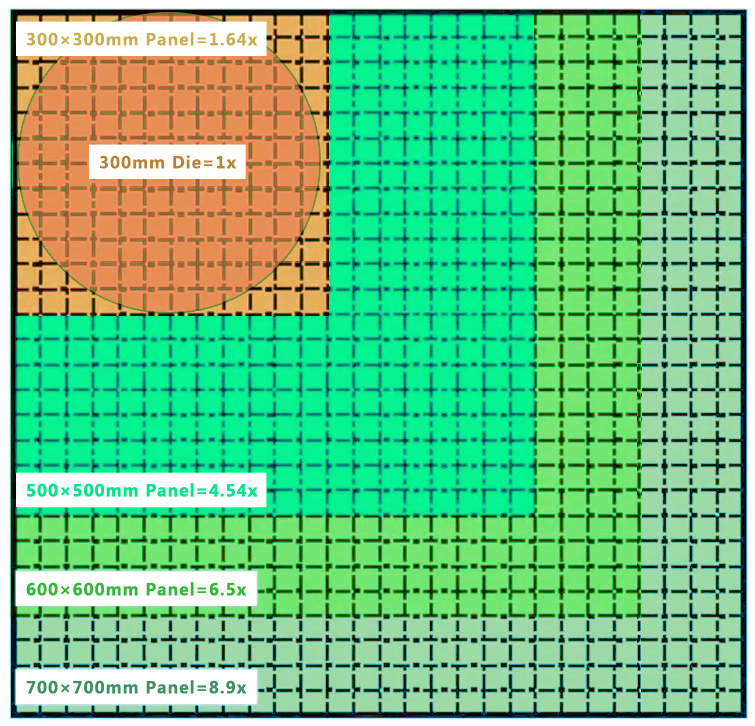
尽管面板级封装有着这些优势,也有着难以克服的天然问题。就是因为面板级封装面积大、芯片数量多,这就需要做面板级封装的Die Bonder既要有大的工作幅面,又要高速度、同时还要高精度,这种技术上的既要又要还要,使得基于Pick&Place技术的传统Die Bonder完全无法满足面板级封装的要求,长期制约了面板级封装发展的。

普莱信面板级刺晶机P-XBonder
普莱信公司勇于技术创新,在其开发的原本用于MiniLED的巨量转移技术XBonder Pro设备基础上,结合面板级封装的技术要求,开发了专用于面板级封装的P-XBonder。P-XBonder采用倒装刺晶方案,从三个方面彻底解决了面板级封装芯片贴装既要还要又要的难题:
1、P-XBonder具有超高的速度,在MiniLED领域,XBonder Pro UPH可以高达200K以上,用于面板级封装,根据不同芯片大小和精度要求,P-XBonder的UPH可以高达120K,让面板级封装的芯片贴装成本直线下降;
2、P-XBonder 可以提供高达5微米的高精度模式,对高精度的板级封装同样实用;
3、P-XBonder最大可以支持900X700基板,全尺寸覆盖了板级封装的要求。在过去几个月,普莱信已经和某国际板级封装的技术领导者和某国际芯片巨头就P-Bonder的进一步应用进行紧密合作,相信随着P-XBonder的推出,将彻底解决板级封装芯片贴装的技术和成本难题,从而推动板级封装的大发展。
普莱信智能一直专注于半导体设备的开发,在传统封装技术和设备日趋成熟,竞争激励的当下,普莱信一直秉承技术领先的发展策略,在MiniLED的巨量转移领域,普莱信的X-Bonder Pro是全球最先进的转移设备,在板级封装领域,P-XBonder将极大推动板级封装技术的发展。同时,普莱信也积极布局各种先进封装技术,为中国芯片行业的发展贡献力量。


 登录
登录