鑫巨半导体成功完成515*510mm大尺寸板级电镀样品,采用新一代高效能、高精度ECD技术,实现2μm L/S超高密度基板的批量制造,达到全球领先水平。鑫巨的设备及工艺技术突破填补了行业空白,这一成就不仅推动了玻璃基板及有机基板等先进封装技术的发展,也为半导体制造和高端电子封装树立了新的行业标杆,进一步巩固了中国企业在全球高端封装领域的竞争力。鑫巨半导体自主研发的各型ECD设备,不仅填补了国内相关领域的空白,更使鑫巨半导体成为了全球唯一一家能够实现高深径比玻璃芯基、玻璃基板TGV填铜、精细纹路、图形沉积的规模化量产设备及工艺解决方案供应商,同时标志着我国半导体装备企业在高端封装领域已构建起完整的技术迭代能力,加速了玻璃基板及有机基板等封装技术的发展,更为全球半导体制造产业链的多元化发展提供了中国方案。
随着集成电路封装密度的不断提升,线宽线距的精度已经成为衡量电子元件性能与集成度的关键因素。板级封装(PLP)作为先进封装技术的重要发展方向,正逐渐成为提升芯片性能、降低成本的重要路径。同时近年来,玻璃基板凭借其低介电损耗、高平整度以及优异的尺寸稳定性,在高端封装领域崭露头角,成为备受市场瞩目的热门技术方向。然而,无论是有机基板还是玻璃基板,目前仍面临5μm以下工艺的瓶颈,难以满足日益增长的超高密度互连需求。ECD技术是半导体制造中不可或缺的核心环节,尤其在先进封装、凸块(Bump)制备、TGV(玻璃通孔)金属化等关键制程中,高精度ECD设备直接决定了芯片的可靠性、导电性能及信号传输效率。随着半导体制造向更高集成度演进,传统摩尔定律逼近物理极限,半导体行业对异质集成和三维堆叠技术的依赖加深,ECD工艺的均匀性、一致性和效率已成为影响先进制程成败的关键性因素。
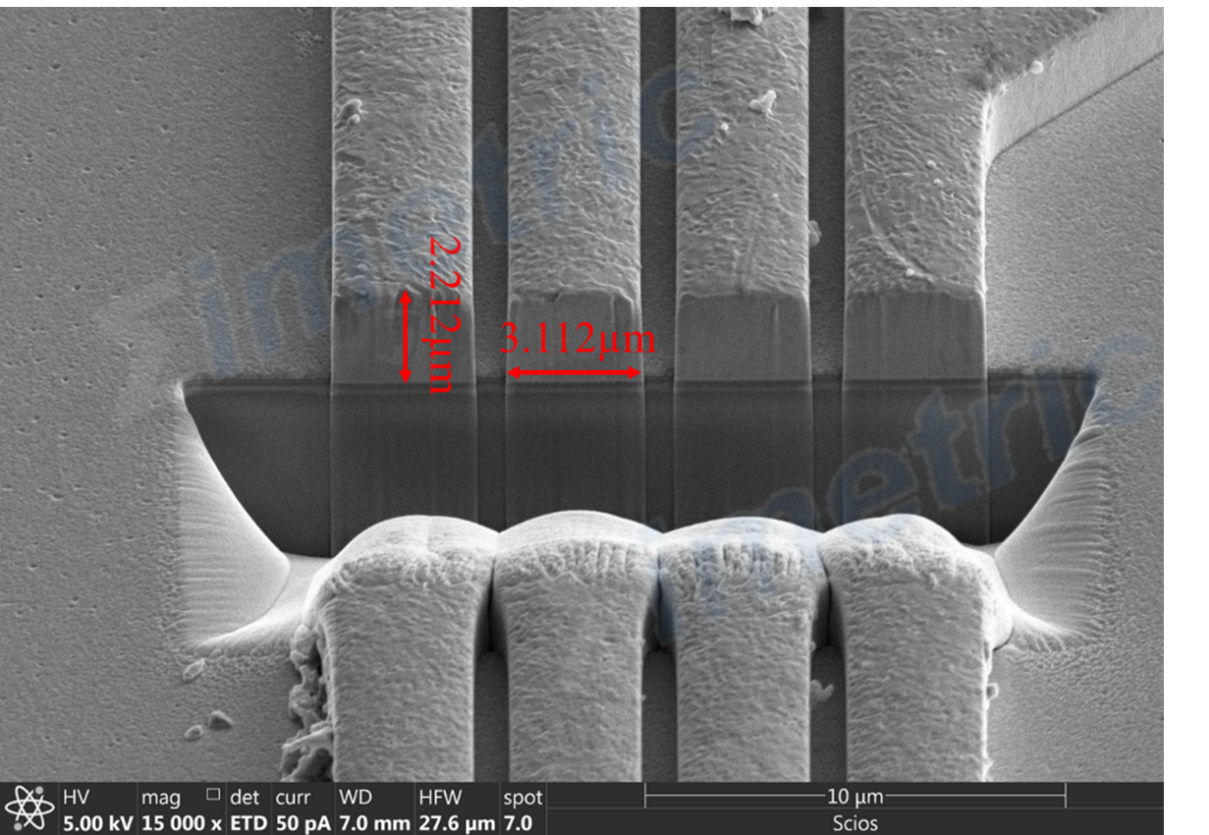
2μm L/S 线路电镀图形FIB结果(闪蚀前)
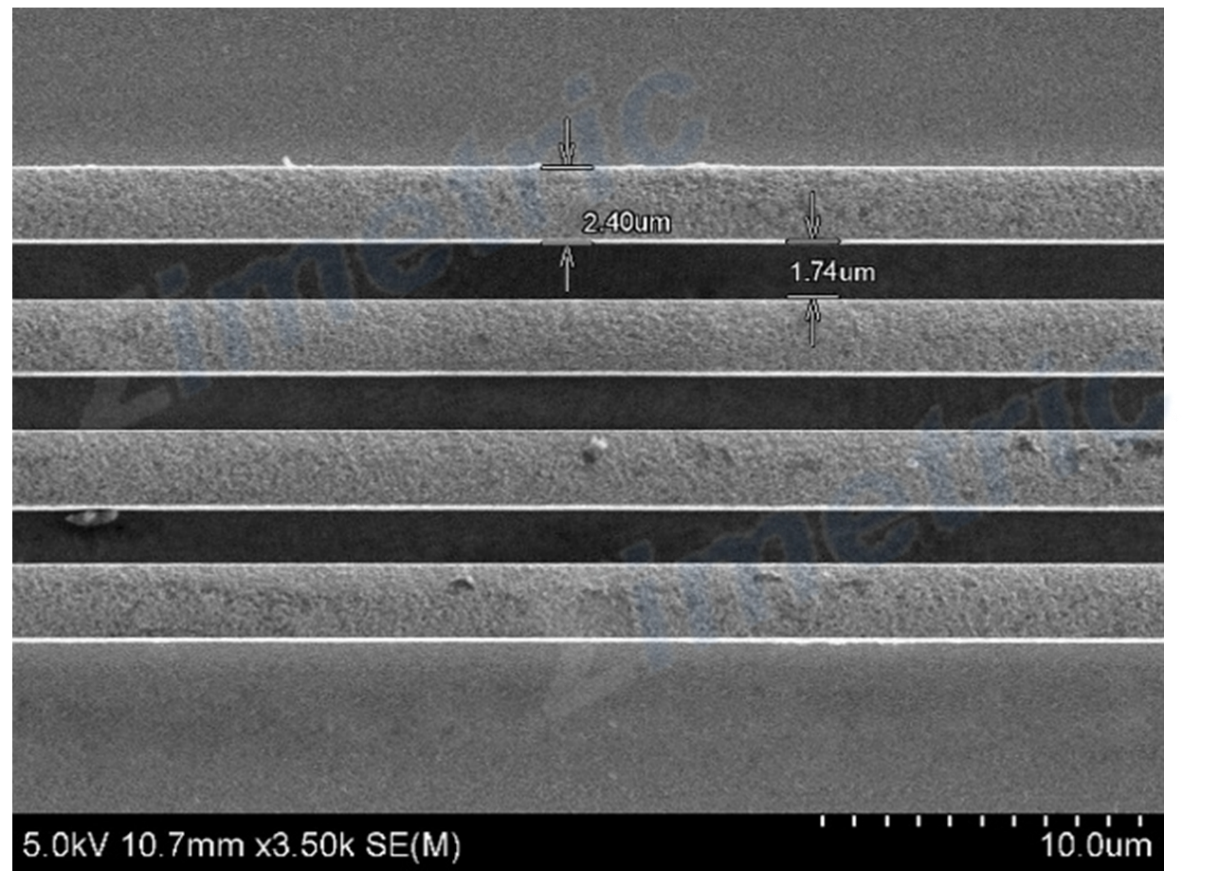
2μm L/S电镀成果(闪蚀后)
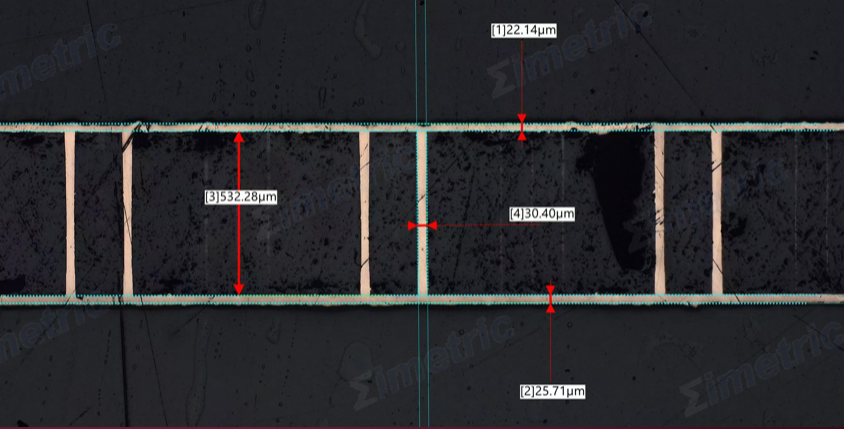
量产需求下AR 1:15填铜
目前,国内当前技术能力仍面临诸多挑战,需要进一步突破,以满足先进封装对高精度、高稳定性的要求。其中,主要技术难点包括:
1. 高均匀性控制:在515*510mm大尺寸基板上,电镀过程中容易受到边缘与中心区域电场分布不均的影响,导致沉积厚度偏差。如何精确优化电流分布,克服电场差异,实现板级WIP 5%以内的高均匀一致性,是行业面临的重要课题。
2. 高深径比TGV填孔:玻璃基板和先进基板封装广泛采用通孔互连(TGV),但深径比(AR)越高,填孔难度越大。鑫巨的ECD电镀技术已成功突破AR 1:15的高深径比填孔,在确保无空洞、无夹杂的同时,实现了高填充率和优异的金属连接性能,为高密度互连提供了强有力的技术支撑。
3. 专业技术支持:针对企业客户的不同工艺需求,鑫巨半导体不仅提供领先的专用设备解决方案,还可提供定制化工艺优化、设备调试及生产技术支持,帮助客户提升工艺稳定性与产品良率,加速实现高密度先进封装终端产品量产落地。
鑫巨半导体凭借其卓越的2μm ECD技术,通过自主正向研发的高效能、高精度工艺,以及精心设计的精密流体控制优化方案,不仅实现了大尺寸基板量产需求下的极致均匀性,还完美解决了高精度微米级线路成型的量产瓶颈。这一创新成果,标志着鑫巨半导体在高端半导体设备制造领域迈出了坚实的一步,为行业的技术进步树立了新的标杆,实现了对国际水平的超越。为国产半导体先进封装行业提供了更高密度、更高性能的解决方案,加速推动玻璃基板及有机基板在高端封装市场的应用。
鑫巨半导体最新ECD设备与技术成果将于SEMICON CHINA上海国际半导体展览会(2025年3月26日至28日,上海新国际博览中心)重磅展出。诚邀莅临展位(N3馆3209),共探技术前沿,携手推动电子制造迈向新未来!