什么是TDR
TDR(时域反射计)被广泛用于电路故障定位。输入脉冲信号在器件内部的电路故障时反射信号,用户可以通过比较好片和坏片之间的时域波形,进而确定故障位置和故障模式(开路或短路)。

通常通过时域反射计(TDR)在单个引线上快速识别缺陷。然而,如果缺陷隐藏在具有多个分支的引线中,由于反射点较多,可能无法理解TDR的波形。基于电光采样的高分辨率时域反射计不仅具有飞秒级的优异分辨率,而且具有更易于理解的脉冲波形,从而有机会从复杂波形中识别缺陷。TDR波形包括缺陷相关反射(DDR)和缺陷独立反射(DIR)。一般来说,一条有缺陷的引线产生的TDR信号(DDR)非常简单:正脉冲从开路(高阻抗)反射;负脉冲从短路(低阻抗)反射。可是线路中跟缺陷无关的部分,比如说分支和寄生,会产生许多复杂和难以理解的反射和多次反射。如果把这些跟缺陷无关的干扰(DIR)叠加到DDR上,就会产生难以理解的TDR波形。
本文将开短归一化方法(OSN)应用于高分辨率时域反射计测量中,以识别带有4个芯片的BUS网络的缺陷位置和缺陷类型。
1.介绍
由于前期反射峰的累积和有限的时间分辨率,在芯片中使用基于示波器的传统时域反射计(TDR)来分析引线分支是一项具有挑战性的任务。在具有阶跃波输入的传统时域反射计中,沿引线的早期反射信号总是叠加后续的反射信号。由于持续累积的噪声,我们很难观察到后期的反射。可以对引线和连接点的每个部分进行繁琐的建模工作,但在实验室中这并不是一个可行的失效分析选项[1-3]。此外,传统时域反射计的典型时间分辨率约为1ps,不足以分析具有亚微米级互连的分支。
高分辨率时域反射计(例如ADVANTEST TS9001 TDR)的情况完全不同。首先,高分辨率时域反射计的输入信号是半峰全宽(FWHM)小于15ps的电脉冲波,将先验反射峰积累限制在脉冲宽度的范围内,并能够分离多次反射。其次, 高分辨率时域反射计利用电光采样具有极低的时间分辨率,低于30 fs,可以分析具有亚微米级互连的分支,并且具有很高的测量再现性 [4,5]。
高分辨率时域反射计的典型示意图如图1所示。它由一种无延迟线的异步采样方法组成[6]。时域反射计分辨率仅受飞秒脉冲激光源抖动的限制,该抖动小于30 fs。缺陷点抽取相应得到改善,距离分辨率小于5 μm,脉冲峰值位置指示清晰,从而有机会在分支引线中识别缺陷。
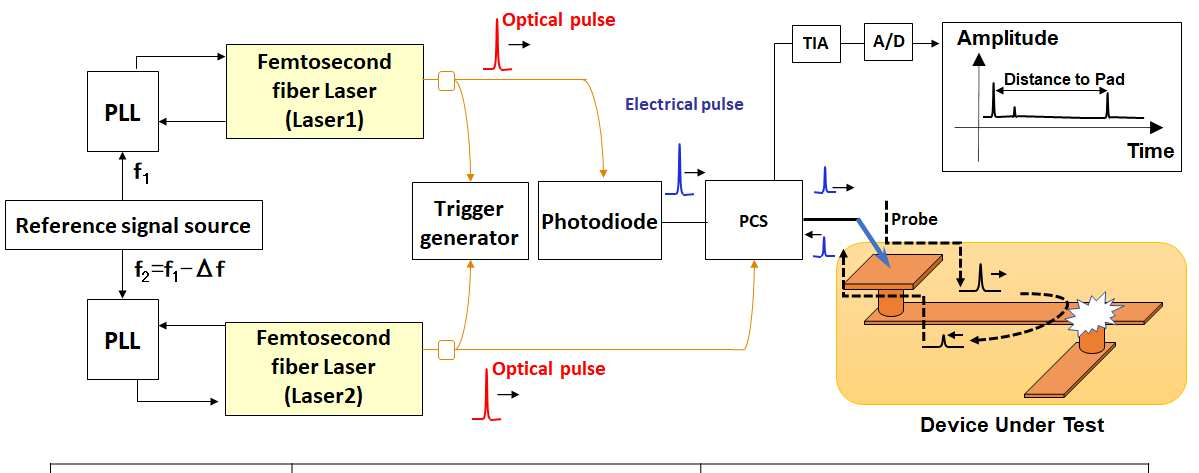

图1 高分辨率时域反射计系统功能图及其与典型传统时域反射计的性能比较
分支引线TDR波形的复杂性可归因于许多反射点,包括连接点和芯片点。此外,在连接点和芯片点之间,或连接点和连接点之间的每个道中都会产生多个反射。所有的反射都会传播回探测点,叠加成一个无法理解的信号。图2(a)为典型的5个分支网络,可以很容易地找到两个连接点和6个多反射环路。好片和坏片的TDR波形如图2(b)所示,对于故障分析工程师来说,缺陷始终是一个谜。
通常,坏片的TDR波形由缺陷相关反射(DDR)和缺陷独立反射(DIR)组成,分别来源于缺陷支路和剩余的良好支路。以图2a中的分支引线为例,如果“Device 1”存在缺陷,则来自Device 1的反射(DDR)会发生变化,而其余良好的芯片(Device 2-5)和连接点反射的信号是相同的(DIR)。开短归一化方法(OSN)可用于从复杂的TDR波形中提取DDR,这可以很容易地理解为它是一条引线 [7]。本文采用高分辨率时域反射计系统,将开短路归一化方法(OSN)应用于4个芯片BUS网络的缺陷识别, 在实测结果得到了验证。

(a)

(b)
图2 (a)具有五个分支的典型网络;(b) (a)中具有B5电阻性短缺陷的网络的TDR波形。
2.开短路归一化方法
OSN可以从坏片的TDR波形中快速提取DDR,随后识别缺陷的位置和缺陷的类型分支多的复杂迹网。
它有三个步骤:
步骤1:在每个可能的缺陷位置做开路和短路的参考
缺陷位置(k)开路的TDR波形为OPEN (k);
缺陷位置(k)短路的TDR波形为SHORT (k)。
以图2(a)中的分支示意图为例,图3为支路1芯片点处于开路和短路时的TDR波形。TDR波形同样可以测量所有其他易受影响的分支。

图3 支路1芯片点的TDR开短路波形
步骤2:得到时间-位置指示器(TLI), DIR和DDR

图4为各芯片(1~5)的时间位置指示TLI。每个芯片的TLI由最早反射时间和最大反射峰的幅值组成
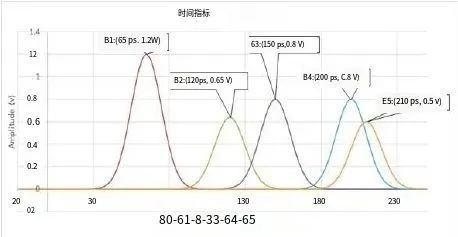
图4 所有分支机构的时间-位置指标
根据TLIs检查图2(b)中的坏片波形,可以快速估计出可能存在缺陷的位置是芯片4和芯片 5(图5)。

图5 根据时间-位置指标的时间,只有芯片4和芯片5是可能导致好片和坏片TDR波形差异的芯片
步骤3:获取缺陷位置和缺陷类型:
缺陷位置通过DDR峰值时间与各自的时间-位置指示器的对齐来识别。
缺陷类型通过缺陷位置的反射系数(k)来识别:{DDR(k)/TLI(k)}
图6显示了缺陷位置在B4时的TLI、DIR和DDR。B4的DDR不能及时与B4的TLI对齐;DDR是一个不对称脉冲响应,这不可能由开路或短路缺陷产生的,由此判断B4不是缺陷的位置。

图6 当芯片4故障时,显示时间定位、DIR和DDR
图7显示了缺陷位置在B5时的TLI、DIR和DDR。由于B5的DDR峰值时间与B5的时间-位置指标有很好的契合度,因此确定B5为缺陷位置。通过计算反射系数为-0.66来进一步获得缺陷的类型,即为电阻性短路缺陷。

图7 当芯片5故障时,查看时间定位、DIR和DDR



 登录
登录







