3月15-16日,第十九届中国半导体封装测试技术与市场年会(CSPT 2021)正式召开。本次会议以“创新引领、协作共赢、共建芯片成品制造产业链”为主题,对芯片成品制造的创新与趋势、封装测试与设备、关键材料等行业热点问题进行研讨。长电科技副总裁陈灵芝发表了题为《芯片成品制造先进技术及其对产业链影响》的演讲。
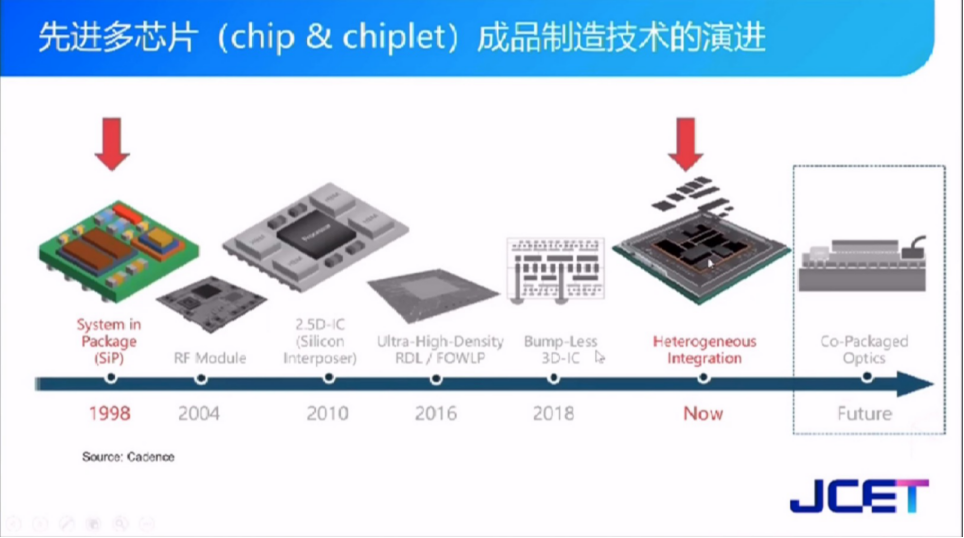
陈灵芝指出,从物联网到万物互联,智能移动终端、数据中心、云服务、无人驾驶、健康管理可穿戴设备、国防航空航天应用等多个应用领域齐头并进,共同驱动着半导体技术的发展。如果从封装角度来看,这些高性能应用也推动着封装技术不断从单芯片封装,向多芯片封装、SiP集成、HD Fan-out、2.5D、3D封装演进。
“不是所有的芯片都需要用先进的7nm、5nm制程,为了充分利用不同节点的制造工艺,我们将SoC根据不同的功能切分成一个个小的芯片或者晶粒,其中一些只需要用成熟的工艺节点来制造,可以避免使用昂贵的先进制程而很好地实现降本。”她强调,“另一方面,把大的芯片切分为小芯片,可以显著地提升良率。因此通过异构集成封装技术,既可以享受成本的最优化,又能做到多功能、高性能的集成。”

应对Chiplet异构集成的需求,长电科技在去年推出了XDFOI™全系列极高密度扇出型封装解决方案,能够有效提高芯片内I/O密度和算力密度的异构集成。该封装解决方案是新型无硅通孔晶圆级极高密度封装技术,相较于2.5D硅通孔(TSV)封装技术,具备更高性能、更高可靠性以及更低成本等特性。该解决方案在线宽或线距可达到2um的同时,可实现多层布线层,另外,采用了极窄节距凸块互联技术,封装尺寸大,可集成多颗芯片、高带宽内存和无源器件。XDFOI™全系列解决方案通过将不同的功能器件整合在系统封装内,大大降低系统成本,缩小封装尺寸,具有广泛的应用场景,主要集中于对集成度和算力有较高要求的FPGA、CPU、GPU、AI和5G网络芯片等应用产品提供Chiplet和异质封装(HiP)的系统封装解决方案。
随着先进芯片成品制造技术的不断发展,硅-光子封装内集成成为未来的封装演进方向之一。陈灵芝表示,硅光子封装内集成可以改善延迟、提高带宽,同时可以显著降低对功率的需求,使Tbps数量级的数据传输成为可能,目前硅光子封装类的集成技术已经有应用,比如英特尔推出的高速收发器,光纤收发模组等产品上都已经使用了相关技术。
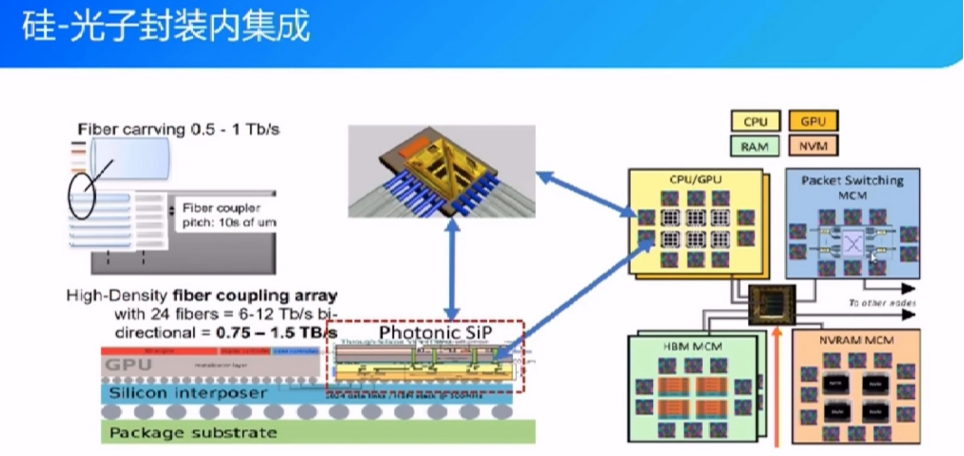
各种技术的发展归根结底是互连密度的不断提升,催生了更高密度的HDB直接键合互连技术。陈灵芝强调,先进芯片成品制造技术推动产业链的整体发展,例如高频高速传输性能催生新的半导体封装材料LCP;硅光集成封装呼唤新的器件及技术的发展,包括离子激光器,离子通信、等离子通信,低损耗的光子连接器,量子点激光等等;长电的高密度细节距XDFOI™技术、Bump等也对PR光刻胶、MUF填料等封装材料提出了更高的需求,这就要求材料供应商、设备供应商等整个产业链也要不断跟进开发,才能促成整个先进封装技术的顺利演进。(校对/Mike)









