
集微网消息,近年来,“跨界”逐渐成为半导体行业的热频词之一,前有跨界造车,后有跨界造芯。但倘若真正论起业内跨界一哥,就不得不提到日本的一家封装材料供应商——味之素。
靠饺子俘获奥运冠军的心,除了味之素再没有第二家公司。今年东京奥运会期间,味之素的速冻饺子在奥运村受到世界各地运动员的欢迎,也因此被冠以“世界上最好吃的饺子”的称谓。鲜味调味料是这其中重要原因之一,也是味之素跨界生产半导体材料的技术基础。
味素营生起家 化学品公司操起“副业”
味之素最初是以味素起家。在日本江户时代中后期,酸、甜、苦、咸仍是食物主要的四种味道。秉持“还存在一个味道”的假设,味之素的事业真正开始了。
1908年,东京帝国大学(东京大学前身)的池田菊苗博士从海带中意外发现了另一种味道来源“谷氨酸钠”(MSG),他将其命名为“鲜味”。次年,味精正式实现商业化买卖。

池田菊苗博士从海带中提取的谷氨酸;来源:味之素
1970年代,味之素开始研究制备谷氨酸钠产生的一些副产物,并对氨基酸衍生环氧树脂及其复合材料展开了基础研究。到1980年代,味之素的专利出现在一批应用于电子工业树脂的研究中。
根据味之素官网信息,该公司在1988开始生产的“PLENSET”是基于潜伏性固化剂技术开发的单组份环氧树脂基粘合剂,该产品目前广泛应用于精密电子元件(如相机模块)、半导体封装和汽车电子等各个领域。其他如:潜伏性固化剂/固化促进剂、偶联剂、颜料分散剂、表面改性填料,以及树脂稳定剂等功能性化学品也在电子、汽车等行业被大量应用。
而随着1990年代计算机市场快速发展,MS-DOS逐渐向Windows操作系统过渡,对多层电路设计的CPU基板需求随之增加。彼时,对防止电路之间发生干扰的绝缘材料需求也真正出现。

ABF薄膜和PLENSET的优势@味之素
1996年,味之素凭借谷氨酸钠相关技术优势,立项研发绝缘材料,正式进入电子材料行业。在味之素看来,半导体封装工序必需的绝缘材料最终会从油墨升级到薄膜。
而这个绝缘薄膜,必须耐用且柔软、轻便且绝缘性极佳。经历多次失败直至1998年秋天,味之素成功开发出ABF膜(Ajinomoto Build-up Film)。紧接着,迎来第一个客户英特尔。
高性能计算成趋势 ABF材料需求大涨
在英特尔主导研发下,ABF材料在电脑CPU市场大放异彩。截至目前,ABF绝缘薄膜几乎占据全球所有主要PC市场100%的份额。不仅如此,ABF也成为IC载板重要的基板材料之一。
数据显示,电路基板是IC载板最大的成本端,占比超过30%。以ABF基板为例,其线路较精密、导电性好、不需要热压过程,适合高脚数高传输IC,多应用于CPU、GPU及芯片组等大型高端芯片。另外,随着半导体生产工艺逼近物理极限,芯片向SoC方向发展加速异构集成技术趋向成熟, ABF已经发展成为高端IC载板主要的增层材料。
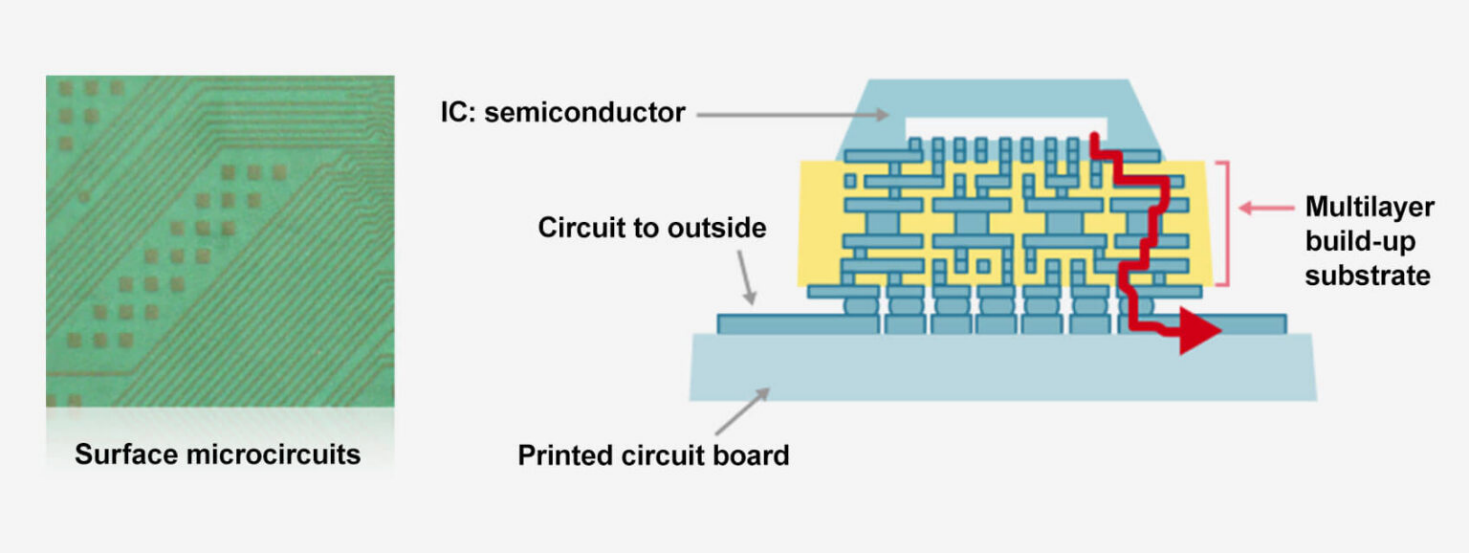
IC载板中的增层材料
尽管如此,在2020年芯片荒全面爆发之前,味之素像其他材料商一样都还是半导体行业的“小透明”。直到IC载板供不应求,市场将问题根源瞄向了这家ABF材料供应商。正如味之素所料,高性能计算(HPC)时代已经来临, ABF材料不可或缺。
Reportlinker在今年7月20日发布的报告中指出,2021- 2026年期间,高性能计算市场预计将以9. 44%的复合年增长率增长。该机构同时指出,2020年先进IC载板市场规模为7.73亿美元,预计到2026年将达到11.07亿美元,预测期内CAGR为6.2% 。
随着5G、工业物联网(IIoT)、人工智能(AI)领域需求增加,以及汽车等市场急速反弹,ABF封装材料交期不断延长。在材料和产业结构性缺货等多重因素作用下,ABF载板开始出现供不应求的局面。
近期就传出,英特尔、AMD、英伟达等大厂正积极与全球ABF载板制造商签订长期合同,以期至少将产能维持到2025年。据美系外资预测,ABF载板明后两年产能短缺程度将分别达到23%、17%。
一家独大背后 长期钻研封装材料开发
在ABF封装材料领域,味之素几乎没有竞争对手,而全球ABF载板市场,也是由中国台湾、日韩厂商主导的寡头垄断市场。信达证券8月份研报指出,尽管味之素已宣布将对ABF材料进行增产,但增产规模较激增的下游需求偏向保守,到2025年产量CAGR仅为14%,导致ABF载板每年产能释放只能达到10%-15%。
在高性能计算芯片需求暴涨的背后,味之素无疑站上了风口浪尖。尽管出于垄断的风险,业界有关增层绝缘材料的研发一直在进行中,比如中国台湾晶化科技研发的Taiwan Build-Up Film (TBF),目前已在岛内外多家厂商验证通过并稳定出货。但是,长期以来的技术积累和创新意识为味之素打下了先发优势。
味之素表示,“随着CPU性能快速提升,ABF质量也在不断提高。这就要求不断研发具有不同性能的绝缘树脂,改进产品特性,满足新兴客户要求的加工技术以及反复进行测试和验证。” 另外因应智能手机功能复杂化和5G高频通信传输要求, ABF绝缘材料的热稳定、散热和低介电等特性将更为重要,这将是味之素乃至打算试水ABF研发的厂商要面临的挑战之一。
除了ABF封装材料,味之素已于2020年开始生产用于半导体封装的焊膏AFTINNOVA™ MP-H701,向封装材料市场再下一城。可以这样形容,味之素在半导体封装材料领域的成功绝非偶然,对“还有一个味道”的假设不断验证是其百年经营而不衰的真谛。(校对/思坦)


 登录
登录








