
集微网报道 据Yole Development数据,高性能技术(HPC)有望引领今年芯片扇出型封装(Fan-Out)市场的增长。而2020年,智能手机和智能手表的应用处理器(AP)占据了Fan-Out市场的大部分。
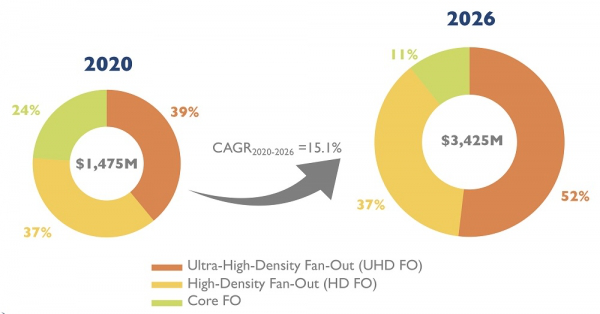
2021年起,Fan-Out封装将得到来自高性能计算的显著增长,这将导致超高密度(UHD)Fan-Out领域的引领增长。据统计,超高密度Fan-Out在2020年占市场的39%,预计到2026年将跃升至52%。而高密度(HD)Fan-Out在2020年占市场37%,到2026年仍将保持这一占比。
Fan-Out作为一种先进封装技术,是延续摩尔定律,提高芯片性能的有效技术。超高密度Fan-Out将应用于云、5G、自动汽车和人工智能芯片,并将引领未来10年的封装趋势。
2020年Fan-Out市场规模14.75亿美元,到2026年,这一规模将达到34.25亿美元,年平均增长率15.1%。
按行业划分,2026年Fan-Out市场中移动和消费市场将达到16.13亿美元,电信和基础设施市场将为15.97亿美元,汽车市场将占2.16亿美元。(校对|Value)


 登录
登录